行业资讯 - 正文
电-热应力下SiC MOSFET器件栅极退化机理研究 2024-03-07 11:21
参考文献:孟鹤立,SiC MOSFET器件栅极与体二极管耦合条件下的退化和失效机理研究【D】,华北电力大学,2023
结论:
(1)SiC MOSFET器件的均流特性同时受VTH漂移和栅极电压上升时间两者的影响。并联SiC MOSFET器件阈值电压相差1V就会带来16.2%的峰值电流差,而栅极电压上升时间的增大也会导致的峰值电流差上升。因此,器件使用过程中必须保证其栅极特性的一致以及栅极驱动的性能,才能最大程度的降低均流问题对器件可靠性带来的影响。
(2)IGSS下降现象的本质是半导体内部的陷阱充电电流减少,不能简单的将其认为是可靠性提升。其下降幅值大小和时间长短与环境因素有密切的相关性,在进行HTGB等可靠性测试时需要关注该现象。
(3)将IGSS退化过程划分为充电区、退化区和失效区。充电区漏电流无法作为失效基准值,需等待漏电流进入退化区后再进行选取。
(4)VTH和IGSS在退化过程中存在耦合关系。IGSS的成份可被分为初始电流、充电电流和退化电流三种,其中初始电流与器件工艺和设计有关,充电电流与阈值电压漂移有关,退化电流则与绝缘性能下降有关。充电电流的大小会影响VTH漂移,在隧穿载流子不足时,会限制陷阱对载流子的捕获,减缓VTH的漂移速度,而当隧穿载流子足够多时,陷阱捕获载流子速度出现饱和,隧穿载流子进一步增多对VTH的影响相对较小。
高温栅偏测试
为对SiC MOSFET器件栅极进行电-热应力下的加速退化,常采用高温栅偏(High Temperature Gate Bias,HTGB)测试。HTGB测试通过电、热双重应力加速器件栅极退化,能激发器件栅氧层缺陷,从而进行器件的栅极可靠性评估、退化机理研究和结构优化设计等。
测试方案和器件
为研究电-热应力对VTH和IGSS的影响,制定了相关的测试方案,不同测试组中栅极电压、场强及环境温度如表2-1所示。测试共分为4组,为避免个体差异带来的误差,每组分别使用3个器件。


被测器件相关电参数特性如表2-2所示。测试过程中,所有器件的VTH测量条件均为VDS=VGS,ID=6mA,而IGSS的测量条件则为VDS=0V,VGs等于测试电压。在对栅极进行击穿测试后得到该器件常温下的棚极击穿电压VG为65V,SiC MOSFET器件的击穿场强Eox约为10MV/cm~11MV/cm,由此可以根据式(2-1)粗略推断出其氧化层厚度tox约为65nm。

栅氧层场强以5MV/cm为分界线,低于5MV/cm漏电流以陷阱辅助隧穿为主,F-N隧穿占比极小,高于5MV/cm时F-N隧穿的数量随场强以指数方式增加。该器件额定栅极电压为20V,场强约为3MV/cm,属于低电场,选择此电压用以研究正常工作状态下漏电流与阈值电压漂移的关系。并进一步选择40V作为测试电压,场强约为6.15MV/cm,用以研究不同成分隧穿的漏电流与阈值电压漂移的关系。与Si器件相比,SiC器件在HTGB测试下的可靠性较差,因此测试时长定为168小时,在确保器件出现明显退化现象的同时加快研究进度。
为排除测试结果的偶然性,需保持器件参数一致,采用静态测试仪对12个被测器件的转移特性曲线进行了测量,结果如图2-4所示。转移特性曲线用来反映VDS恒定时,VGS和ID之间的关系,可获得VTH和通流能力等信息,所有被测器件的转移特性均具有高度的一致性,因此在结果分析的过程中可以排除被测器件差异带来的影响。

为充分研究电-热应力下VTH与IGss的耦合关系,VTH与IGss测量均在测试电压和温度下进行。一般情况下,HTGB测试的目的是为了对栅极寿命进行统计和分析,因此需要统一测量条件和环境。而本测试的目的在于研究电-热应力影响下的电参数变化机理及其耦合关系,如若将测量条件设置为常温(30℃)常电压(20V),则由于陷阱的恢复特性,无法准确观察其在不同电-热应力下的电参数变化,更无法进一步深入研究电-热应力影响下两者的耦合关系,因此,无法解释实际工况中,在高结温和高场强情况下的栅氧层电特性变化,在测试环境下进行测量有利于为失效分析提供理论依据。
测试结果
电-热应力作用下,SiC MOSFET器件IGSS与时间的关系如图2-5所示。除测试组1(150℃,20V)外,测试结果均表现出下降趋势,并最终趋于稳定。该现象也存在于己公开发表的文献中,研究表明IGSS下降并不代表器件的可靠性提升。为方便对比不同环境下的IGSS下降幅度,对每组样品的测试结果取平均值,如图2-7(a)所示:175℃/40V下的平均值为170.2pA,175℃/20V下的平均值为78.8pA,150℃/40V下的平均值为29.3pA,150℃/20V下的平均值为8pA。因此,IGSS下降的幅度与电-热应力有正相关性,热应力越高,电应力越强,IGSS下降幅度越大。
电-热应力作用下,SiC MOSFET器件VrH与时间的关系如图2-6所示。所有测试条件下的VH均出现了正漂移。同样地,为方便对比不同环境下的VTH上升幅度,对每组样品的测试结果取平均值,如图2-7(b)所示:175℃/40V下的平均值为250mV,175℃/20V下的平均值为66.7mV,150℃/40V下的平均值为220mV,150℃/20V下的平均值为21.7V。因此,VTH的上升幅度也与电-热应力有正相关性,热应力越高,电应力越强,VTH的上升幅度越大。
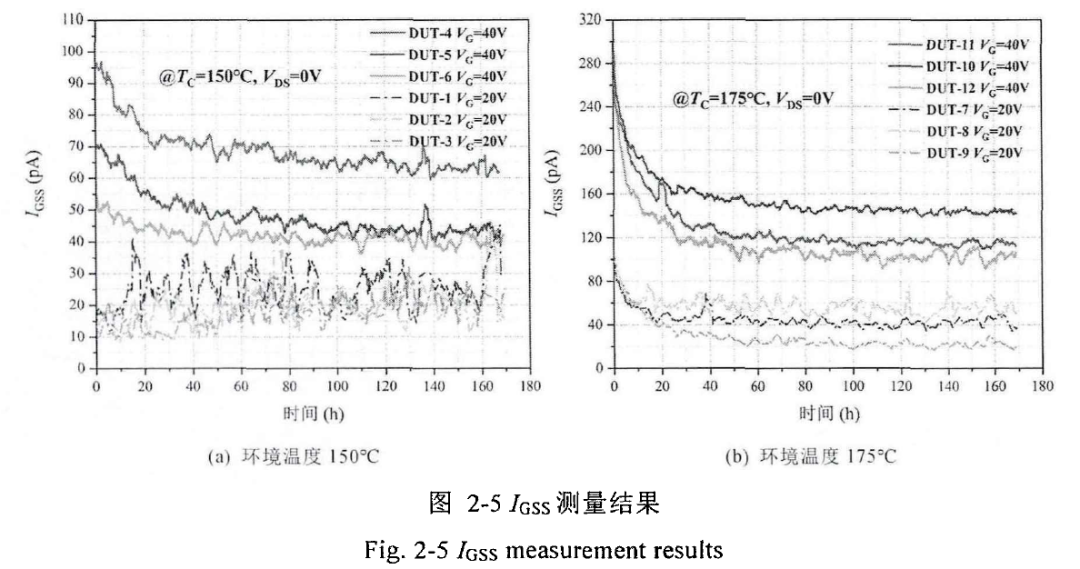

IGss快速下降并趋于稳定,而VTH则稳步上升。以最终值的10%为稳定值,可以得到不同测试组中VTH和IGSS的稳定时间,如图2-8所示。由于测试组1测量结果受干扰信号影响较大,因此无法计算其稳定时间。IGSS的平均稳定时间为175℃/40V下35.9小时,175℃/20V下30.15小时,150℃140V下69.7小时。VTH的平均稳定时间为175℃/40V下137.7小时,175°C/20V下141小时,150℃/40V下134.7小时。进一步地,结合变化幅度可以得出不同测试条件下的IGSS下降速度排序为175℃/40V>175℃/20V>150℃/40V。VTH上升速度排序为175℃/40V>150℃/40V>175℃/20V。基于以上测试结果,测试组4的变化幅度和变化速度均为最大,测试组1变化最小。


测试组1为150℃/20V的低热应力和低电应力,由于低热应力和弱电应力引起的隧穿不足和陷阱激活较少,VTH和IGss均无明显退化现象。这也说明了该型号器件在额定工况下栅极有极高的稳定性。
测试组2为150℃/40V的低热应力和强电应力。在强电应力作用下,F-N隧穿率增加,IGSS初始值增加。同样,更多浅近界面氧化层陷阱捕获的电子进入深能级,因此VTH快速升高。而相对于175℃,初始状态下陷阱填充率高,随时间推移,被填充的界面陷阱和浅近界面陷阱少,IGSS下降幅度小。
测试组3为175℃/20V的高热应力和弱电应力。在高热应力作用下,陷阱填充率低,且势垒降低,隧穿率增加,因此IGss初始值增加,而随着界面陷阱和浅近界面陷阱在电-热应力的作用下快速被占据,FN隧穿率和陷阱辅助隧穿率同时下降,此时陷阱对势垒的提升大大减弱了温度对势垒的降低,IGSS快速下降。而弱电应力作用下,浅近界面氧化层陷阱捕获的电子很难进入深近界面氧化层陷阱,因此VTH的上升缓慢。
对比测试组2和测试组3的测量结果。两者的VT和IGss起始值接近。测试组3的IGSS下降速度更快,变化幅度更大。而测试组2的VTH上升速度更快,变化幅度更大。
测试组4是最为严苛的环境。在高热应力和强电应力的共同作用下,一方面,初始状态有更多的弱键断裂,形成了新的陷阱,当时间=0时,由于界面陷阱和浅近界面氧化层陷阱的增加,虽然陷阱填充率的下降,但强电场快速填充了陷阱,VTH升高。同时,陷阱的增加有利于电子的陷阱辅助隧穿,而温度和电场的增加降低了势垒,增加了F-N隧穿,因此IGSS初始值升高。另一方面,强电场和高温增加了电子在SO2中的碰撞电离,促进了电子空穴对的生成,进一步提升了陷阱数量,新生成的界面陷阱和浅近界面氧化层陷阱会捕获电子成为负极性,升高了势垒,降低IGSS。而强电应力作用下,被捕获的电子也会向深能级陷阱迁移,促使VTH进一步上升。因此,在175℃/40V时,VTH和IGSS有着高起始值,高变化速度和高变化幅度。
版权归原作者所有,转发请注明出处,如有侵权请联系秘书处删除。
结论:
(1)SiC MOSFET器件的均流特性同时受VTH漂移和栅极电压上升时间两者的影响。并联SiC MOSFET器件阈值电压相差1V就会带来16.2%的峰值电流差,而栅极电压上升时间的增大也会导致的峰值电流差上升。因此,器件使用过程中必须保证其栅极特性的一致以及栅极驱动的性能,才能最大程度的降低均流问题对器件可靠性带来的影响。
(2)IGSS下降现象的本质是半导体内部的陷阱充电电流减少,不能简单的将其认为是可靠性提升。其下降幅值大小和时间长短与环境因素有密切的相关性,在进行HTGB等可靠性测试时需要关注该现象。
(3)将IGSS退化过程划分为充电区、退化区和失效区。充电区漏电流无法作为失效基准值,需等待漏电流进入退化区后再进行选取。
(4)VTH和IGSS在退化过程中存在耦合关系。IGSS的成份可被分为初始电流、充电电流和退化电流三种,其中初始电流与器件工艺和设计有关,充电电流与阈值电压漂移有关,退化电流则与绝缘性能下降有关。充电电流的大小会影响VTH漂移,在隧穿载流子不足时,会限制陷阱对载流子的捕获,减缓VTH的漂移速度,而当隧穿载流子足够多时,陷阱捕获载流子速度出现饱和,隧穿载流子进一步增多对VTH的影响相对较小。
高温栅偏测试
为对SiC MOSFET器件栅极进行电-热应力下的加速退化,常采用高温栅偏(High Temperature Gate Bias,HTGB)测试。HTGB测试通过电、热双重应力加速器件栅极退化,能激发器件栅氧层缺陷,从而进行器件的栅极可靠性评估、退化机理研究和结构优化设计等。
测试方案和器件
为研究电-热应力对VTH和IGSS的影响,制定了相关的测试方案,不同测试组中栅极电压、场强及环境温度如表2-1所示。测试共分为4组,为避免个体差异带来的误差,每组分别使用3个器件。


被测器件相关电参数特性如表2-2所示。测试过程中,所有器件的VTH测量条件均为VDS=VGS,ID=6mA,而IGSS的测量条件则为VDS=0V,VGs等于测试电压。在对栅极进行击穿测试后得到该器件常温下的棚极击穿电压VG为65V,SiC MOSFET器件的击穿场强Eox约为10MV/cm~11MV/cm,由此可以根据式(2-1)粗略推断出其氧化层厚度tox约为65nm。

栅氧层场强以5MV/cm为分界线,低于5MV/cm漏电流以陷阱辅助隧穿为主,F-N隧穿占比极小,高于5MV/cm时F-N隧穿的数量随场强以指数方式增加。该器件额定栅极电压为20V,场强约为3MV/cm,属于低电场,选择此电压用以研究正常工作状态下漏电流与阈值电压漂移的关系。并进一步选择40V作为测试电压,场强约为6.15MV/cm,用以研究不同成分隧穿的漏电流与阈值电压漂移的关系。与Si器件相比,SiC器件在HTGB测试下的可靠性较差,因此测试时长定为168小时,在确保器件出现明显退化现象的同时加快研究进度。
为排除测试结果的偶然性,需保持器件参数一致,采用静态测试仪对12个被测器件的转移特性曲线进行了测量,结果如图2-4所示。转移特性曲线用来反映VDS恒定时,VGS和ID之间的关系,可获得VTH和通流能力等信息,所有被测器件的转移特性均具有高度的一致性,因此在结果分析的过程中可以排除被测器件差异带来的影响。

为充分研究电-热应力下VTH与IGss的耦合关系,VTH与IGss测量均在测试电压和温度下进行。一般情况下,HTGB测试的目的是为了对栅极寿命进行统计和分析,因此需要统一测量条件和环境。而本测试的目的在于研究电-热应力影响下的电参数变化机理及其耦合关系,如若将测量条件设置为常温(30℃)常电压(20V),则由于陷阱的恢复特性,无法准确观察其在不同电-热应力下的电参数变化,更无法进一步深入研究电-热应力影响下两者的耦合关系,因此,无法解释实际工况中,在高结温和高场强情况下的栅氧层电特性变化,在测试环境下进行测量有利于为失效分析提供理论依据。
测试结果
电-热应力作用下,SiC MOSFET器件IGSS与时间的关系如图2-5所示。除测试组1(150℃,20V)外,测试结果均表现出下降趋势,并最终趋于稳定。该现象也存在于己公开发表的文献中,研究表明IGSS下降并不代表器件的可靠性提升。为方便对比不同环境下的IGSS下降幅度,对每组样品的测试结果取平均值,如图2-7(a)所示:175℃/40V下的平均值为170.2pA,175℃/20V下的平均值为78.8pA,150℃/40V下的平均值为29.3pA,150℃/20V下的平均值为8pA。因此,IGSS下降的幅度与电-热应力有正相关性,热应力越高,电应力越强,IGSS下降幅度越大。
电-热应力作用下,SiC MOSFET器件VrH与时间的关系如图2-6所示。所有测试条件下的VH均出现了正漂移。同样地,为方便对比不同环境下的VTH上升幅度,对每组样品的测试结果取平均值,如图2-7(b)所示:175℃/40V下的平均值为250mV,175℃/20V下的平均值为66.7mV,150℃/40V下的平均值为220mV,150℃/20V下的平均值为21.7V。因此,VTH的上升幅度也与电-热应力有正相关性,热应力越高,电应力越强,VTH的上升幅度越大。
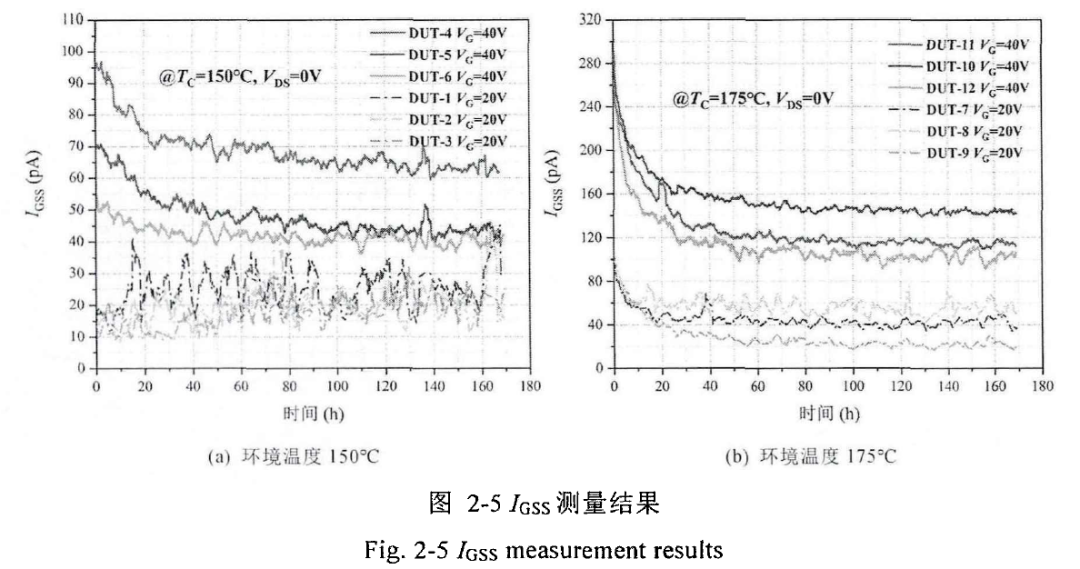

IGss快速下降并趋于稳定,而VTH则稳步上升。以最终值的10%为稳定值,可以得到不同测试组中VTH和IGSS的稳定时间,如图2-8所示。由于测试组1测量结果受干扰信号影响较大,因此无法计算其稳定时间。IGSS的平均稳定时间为175℃/40V下35.9小时,175℃/20V下30.15小时,150℃140V下69.7小时。VTH的平均稳定时间为175℃/40V下137.7小时,175°C/20V下141小时,150℃/40V下134.7小时。进一步地,结合变化幅度可以得出不同测试条件下的IGSS下降速度排序为175℃/40V>175℃/20V>150℃/40V。VTH上升速度排序为175℃/40V>150℃/40V>175℃/20V。基于以上测试结果,测试组4的变化幅度和变化速度均为最大,测试组1变化最小。


测试组1为150℃/20V的低热应力和低电应力,由于低热应力和弱电应力引起的隧穿不足和陷阱激活较少,VTH和IGss均无明显退化现象。这也说明了该型号器件在额定工况下栅极有极高的稳定性。
测试组2为150℃/40V的低热应力和强电应力。在强电应力作用下,F-N隧穿率增加,IGSS初始值增加。同样,更多浅近界面氧化层陷阱捕获的电子进入深能级,因此VTH快速升高。而相对于175℃,初始状态下陷阱填充率高,随时间推移,被填充的界面陷阱和浅近界面陷阱少,IGSS下降幅度小。
测试组3为175℃/20V的高热应力和弱电应力。在高热应力作用下,陷阱填充率低,且势垒降低,隧穿率增加,因此IGss初始值增加,而随着界面陷阱和浅近界面陷阱在电-热应力的作用下快速被占据,FN隧穿率和陷阱辅助隧穿率同时下降,此时陷阱对势垒的提升大大减弱了温度对势垒的降低,IGSS快速下降。而弱电应力作用下,浅近界面氧化层陷阱捕获的电子很难进入深近界面氧化层陷阱,因此VTH的上升缓慢。
对比测试组2和测试组3的测量结果。两者的VT和IGss起始值接近。测试组3的IGSS下降速度更快,变化幅度更大。而测试组2的VTH上升速度更快,变化幅度更大。
测试组4是最为严苛的环境。在高热应力和强电应力的共同作用下,一方面,初始状态有更多的弱键断裂,形成了新的陷阱,当时间=0时,由于界面陷阱和浅近界面氧化层陷阱的增加,虽然陷阱填充率的下降,但强电场快速填充了陷阱,VTH升高。同时,陷阱的增加有利于电子的陷阱辅助隧穿,而温度和电场的增加降低了势垒,增加了F-N隧穿,因此IGSS初始值升高。另一方面,强电场和高温增加了电子在SO2中的碰撞电离,促进了电子空穴对的生成,进一步提升了陷阱数量,新生成的界面陷阱和浅近界面氧化层陷阱会捕获电子成为负极性,升高了势垒,降低IGSS。而强电应力作用下,被捕获的电子也会向深能级陷阱迁移,促使VTH进一步上升。因此,在175℃/40V时,VTH和IGSS有着高起始值,高变化速度和高变化幅度。
版权归原作者所有,转发请注明出处,如有侵权请联系秘书处删除。

